O IGBT (Insulated Gate Bipolar Transistor)
I . Introdução
Desde a invenção do primeiro tiristor de junção PNPN, pelos laboratórios Bell em 1957, houve um grande avanço nos dispositivos semicondutores de potência.
Para serem aplicados em sistemas de elevada potência e substituírem as rudimentares válvulas ignitron, phanotron e thyratron, os dispositivos semicondutores devem ser capazes de suportar grandes correntes e elevadas tensões reversas em seu chaveamento. Além disso, em várias aplicações de eletrônica de potência, há necessidade de uma operação em elevadas freqüências de chaveamento dos dispositivos semicondutores, como, por exemplo, os inversores de tensão, necessários para a construção de filtros ativos de potência. Dessa forma, os dispositivos semicondutores devem possuir baixas perdas de potência durante o chaveamento.
Até 1970, os tiristores convencionais foram exclusivamente usados para o controle de potência em aplicações industriais. Desde 1970, vários tipos de dispositivos semicondutores de potência foram desenvolvidos e se tornaram disponíveis comercialmente. Estes dispositivos podem ser amplamente divididos em cinco tipos: os diodos de potência, os tiristores, os transistores bipolares de junção de potência, os MOSFET’s de potência, os SIT’s (Static Induction Transistor) e os IGBT’s (Insulated Gate Bipolar Transistor), assunto desta dissertação.
Reunindo as características de comutação dos transistores bipolares de potência à elevada impedância de entrada dos MOSFET’s, o IGBT se torna cada vez mais popular nos circuitos de controle de potência de uso industrial e até mesmo em eletrônica de consumo e embarcada.
Os transistores bipolares de potência possuem características que permitem sua utilização no controle de elevadas correntes com muitas vantagens, como baixas perdas no estado de condução. No entanto, as suas características de entrada, exigindo correntes elevadas de base, já que operam como amplificadores de corrente, trazem certas desvantagens em algumas aplicações.
Por outro lado, os transistores de efeito de campo MOS de potência podem também controlar potências elevadas com muitas vantagens pelo fato de exigirem tensão para o disparo, pois, embora sejam dispositivos de alta impedância têm como desvantagem uma baixa velocidade de comutação devida às capacitâncias de porta (Gate) que aumentam com a intensidade de corrente (Largura do canal) que deve ser controlada. No entanto, para baixas correntes de condução através do canal, o MOSFET pode operar com elevadas freqüências.
O IGBT reúne a facilidade de acionamento dos MOSFET’s e sua elevada impedância de entrada com as pequenas perdas em condução dos TBP (Transistores Bipolares de Potência). Sua velocidade de chaveamento é determinada, a princípio, pelas características mais lentas – as quais são devidas às características do TBP. Assim, a velocidade dos IGBT’s é semelhante à dos TBP; no entanto, nos últimos anos tem crescido gradativamente, permitindo a sua operação em freqüências de dezenas de kHz, nos componentes para correntes na faixa de dezenas e até centenas de Ampères.
Juntando o que há de bom nesses dois tipos de transistores, o IGBT é um componente que se torna cada vez mais recomendado para comutação de carga de alta corrente em regime de alta velocidade.
Abaixo, apresentamos um gráfico contendo uma comparação entre os principais dispositivos semicondutores de potência quanto às suas características de tensão, corrente e freqüência de operação. Nesta figura, vemos que os tiristores são os dispositivos que conseguem suportar os maiores valores de corrente e tensão, mas não podem operar em freqüências de chaveamento elevadas. Como podemos ver a partir desta figura, os IGBT’s possuem uma capacidade de suportar maiores tensões e podem operar em mais altas freqüências que os transistores bipolares de potência e podem suportar maiores tensões e correntes que os MOSFET’s de potência. Como podemos notar a partir deste gráfico, a região de operação segura do IGBT é maior que as regiões reservadas ao MOSFET e ao transistor TBP, o que era desejado.

Apresentamos aqui nesta dissertação como operam fisicamente os IGBT’s e apresentaremos o modelo para descrição do seu funcionamento. Serão também mostradas as páginas do manual de um fabricante de IGBT para ilustrar as características de operação deste dispositivo. Por fim, será apresentada uma aplicação dos IGBT’s em eletrônica de potência para mostrar a utilidade do dispositivo.
II . Operação Física do IGBT
Na figura a seguir, apresentamos a estrutura de um típico IGBT de canal tipo N. Todas as discussões apresentadas aqui estão relacionadas com o dispositivo de canal tipo N, pois o canal tipo P é análogo e possui uma operação física dual àquela apresentada para o de canal tipo N.
Sua estrutura muito semelhante àquela apresentada por um transistor MOSFET. Onde, no caso o IGBT, teremos uma dupla difusão de uma região do tipo P e uma do tipo N.
Abaixo da região da porta (Gate), uma camada de inversão pode ser formada a partir da aplicação de uma certa tensão entre a porta e o emissor (emitter), tal como é feito em um MOSFET para fazê-lo entrar em condução.
A principal diferença entre essa estrutura do IGBT e a de um MOSFET é a inclusão de um substrato P+ (O símbolo “+” foi colocado para indicar que esta região é fortemente dopada, enquanto que o símbolo “-” indica que a região é fracamente dopada) onde é conectado o terminal de coletor (collector). Esta mudança tem como efeito a inclusão de características bipolares ao dispositivo. Esta camada P+ tem como objetivo a inclusão de portadores positivos – lacunas – na região de arrastamento (Drift region) como é feito em um transistor bipolar do tipo pnp.
Na estrutura do IGBT, é importante notar que o terminal de porta está conectado à duas regiões – isoladas do material semicondutor através de uma camada isolante de óxido de silício (SiO2) – ao invés de ser apenas uma região como costumamos ver em MOSFET’s. Assim, como veremos, o IGBT apresenta formação de dois canais ao invés de apenas um.
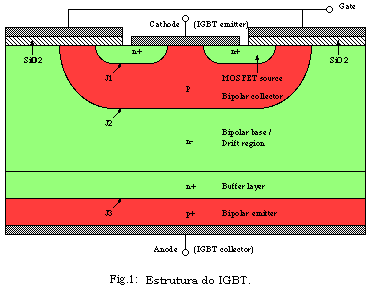
O IGBT é freqüentemente utilizado como uma chave, alternando os estados de condução (On-state) e corte (Off-state) os quais são controlados pela tensão de porta, assim como em um MOSFET.
Se aplicarmos uma pequena tensão de porta positiva em relação ao emissor, a junção J1 da figura anterior ficará reversamente polarizada e nenhuma corrente irá circular através dessa junção. No entanto, a aplicação de uma tensão positiva no terminal de porta fará com que se forme um campo elétrico na região de óxido de silício responsável pela repulsão das lacunas pertencentes ao substrato tipo P e a atração de elétrons livres desse mesmo substrato para a região imediatamente abaixo da porta.
Enquanto não houver condução de corrente na região abaixo dos terminais de porta, não haverá condução de corrente entre o emissor e o coletor porque a junção J2 estará reversamente polarizada, bloqueando a corrente. A única corrente que poderá fluir entre o coletor e o emissor será a corrente de escape (leakage).
Uma característica desta região de operação é a tensão direta de breakdown, determinada pela tensão breakdown da junção J2. Este é um fator extremamente importante, em particular para dispositivos de potência onde grandes tensões e correntes estão envolvidas. A tensão de breakdown da junção J2 é dependente da porção mais fracamente dopada da junção, isto é, a camada N- . Isto s deve ao fato de que a camada mais fracamente dopada resulta em uma região de depleção desta junção mais larga. Uma região de depleção mais larga implica em um valor máximo de campo elétrico na região de depleção que o dispositivo poderá suportar sem entrar em breakdown mais baixo, o que implica no fato de que o dispositivo poderá suportar altas tensões na região de corte. Esta é a razão pela qual a região N- da região de arrastamento é mais levemente dopada que a região tipo P da região de corpo (Body). Os dispositivos práticos geralmente são projetados para possuírem uma tensão de breakdown entre 600 V e 1200 V.
Ao aplicarmos uma tensão entre porta e emissor do dispositivo, fazendo a porta possuir uma tensão positiva com relação ao emissor, uma corrente de pequena intensidade e de curta duração circula pela porta de forma a carregar a capacitância parasita que existe entre a porta e a porção semicondutora logo abaixo do terminal de porta. Como já foi dito, a tensão faz com que um campo elétrico apareça entre o terminal de porta e a porção de semicondutor p logo abaixo da porta. Este campo elétrico atrai alguns elétrons livres da própria região tipo p e alguns elétrons livres das porções n+ localizadas dentro desse substrato p, em virtude do fato de essa região estar fortemente dopada. Ao aumentarmos a tensão entre a porta e o emissor, conseqüentemente, aumentaremos esse campo elétrico e mais portadores negativos serão atraídos para a região imediatamente abaixo do terminal de porta.
Quando a tensão entre a porta e o emissor atinge um determinado valor limite – que depende do dispositivo – conhecida como tensão de limiar (threshold voltage), simbolizada por Vth, a quantidade de elétrons livres atraídos pelo campo elétrico é tamanha que a região imediatamente abaixo da porta acaba por se transformar do tipo p para o tipo n, fenômeno conhecido como inversão – sendo a camada que sofreu o processo recebe o nome de camada de inversão, mais comumente conhecida como canal.
Com a formação deste canal, temos uma ligação do tipo n entre a pequena região n+ e a região de arrastamento, tal canal permite a condução de corrente através de uma pequena região na junção J1 que estava reversamente polarizada antes de a tensão entre porta e emissor atingir o valor limiar. Dessa forma, elétrons serão transportados através deste canal até a região de arrastamento onde irão fazer parte da corrente que circula pela junção J3 que está diretamente polarizada, fazendo com que o “diodo” formado pela junção J3 entre em condução. Com este efeito, temos que a camada p+ conectada ao coletor injeta lacunas positivamente carregadas na região de arrastamento n-.
Essa injeção de lacunas da região de arrastamento causa a modulação da condutividade da região de arrastamento onde as densidades de ambos os portadores, elétrons livres e lacunas, atingem valores muito mais elevados que àquela que a região n- geralmente apresenta. É esta modulação de condutividade que dá ao IGBT sua baixa tensão de condução entre os terminais de coletor e emissor do IGBT por causa da reduzida resistência da região de arrastamento – isto se deve ao fato de que a condutividade de um material semicondutor é proporcional à densidade de portadores deste material. Assim, o IGBT poderá drenar correntes elevadas com poucas perdas de potência, assim como o que ocorre em um transistor bipolar.
Algumas das lacunas injetadas na região n- são recombinadas nesta mesma região com os elétrons livres desta camada. No entanto, a maior parte das lacunas que alcançam a região não se recombinam e alcançam a junção J2 que está reversamente polarizada. Assim, as lacunas encontram um campo elétrico favorável ao seu movimento, justamente por causa da polarização reversa da junção. Com este campo elétrico da junção J2, as lacunas serão arrastadas por meio da corrente de difusão pela região de arrastamento atravessando a junção J2 até serem coletadas pela região do tipo p onde está conectado o terminal de coletor.
A operação física do IGBT descrita aqui é ilustrada na figura apresentada abaixo:
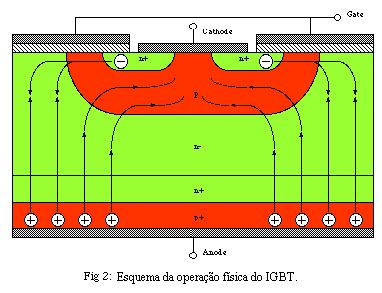
Analisando a figura acima e verificando como é a operação física do IGBT, podemos facilmente deduzir um modelo para descrever o funcionamento do dispositivo usando apenas componentes eletrônicos conectados de forma a funcionar de modo equivalente ao IGBT. Olhando a figura acima, vemos que temos ao longo do dispositivo três fatias de semicondutores formando uma junção PNP que é a mesma que forma um transistor bipolar de potência cuja base é conectada à região central e os terminais de coletor e emissor são conectados do mesmo modo que no TBP. Na parte de cima da figura, temos uma estrutura que opera exatamente como um MOSFET de potência cuja corrente de dreno é injetada na região de arrastamento que corresponde à base do transistor PNP de potência que temos ao longo do IGBT. Essa corrente de dreno do MOSFET atua como o disparo do transistor. Assim, podemos modelar o IGBT pelo circuito equivalente da figura abaixo.
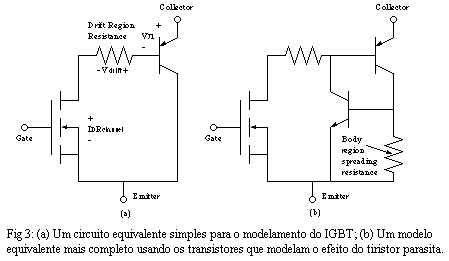
A figura 3 (b) mostra um modelo mais completo para o circuito equivalente do IGBT que inclui o transistor parasita pela região tipo n+ da fonte do MOSFET, a região de corpo do MOSFET do tipo p e a região de arrastamento tipo n-. Neste modelo também é apresentada a resistência lateral da região tipo pda região de corpo. Se a corrente fluindo através dessa resistência for elevada o suficiente, teremos uma queda de tensão que irá polarizar diretamente a junção entre esta camada semicondutora e a região n+ ativando o transistor parasita que forma um tiristor parasita juntamente com o transistor PNP principal da estrutura do IGBT. Uma vez que o tiristor tenha sido disparado, há uma elevada injeção de elétrons livres oriundos da região tipo n+ na região tipo p do substrato do MOSFET, fazendo com que a tensão de gate não influa mais na operação do dispositivo – assim como o que ocorre com os tiristores – fazendo com que o controle da operação do IGBT seja perdido. Este fenômeno – denominado latch-up –, quando ocorre, geralmente conduz à destruição do dispositivo. Geralmente, os fabricantes de IGBT constroem o molde da superfície do emissor em forma de uma tira estreita, enquanto que a geometria utilizada em MOSFET’s é baseada em células concentradas, tal fato permite que se evite o disparo do tiristor parasita existente na estrutura do IGBT.
Na figura apresentada a seguir, temos o símbolo utilizado em circuitos para designar o IGBT. Neste símbolo vemos detalhes que lembram tanto o símbolo usado para transistores bipolares como o símbolo usado para MOSFET’s. Também apresentamos um desenho do aspecto do IGBT produzido como componente discreto pela International Rectifier.
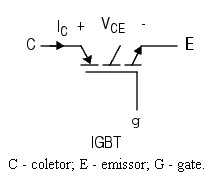

Os IGBT’s são componentes usados principalmente como comutadores em conversores de freqüência, inversores etc. Nestas aplicações, normalmente uma carga indutiva é ligada e desligada, podendo com isso aparecer tensões inversas elevados, contra as quais o dispositivo deve ser protegido. Essa proteção é feita com o uso de diodos ligados em paralelo com o coletor e o emissor para evitar que uma elevada tensão reversa seja aplicada ao IGBT. Quando o IGBT liga novamente, o fluxo de corrente no diodo funciona inicialmente como se fosse praticamente um curto. A carga armazenada tem que ser removida inicialmente para que o diodo bloqueie a tensão. Isso faz com que apareça uma corrente que se soma à corrente de carga a qual é chamada de corrente reversa de recuperação do diodo IRR. O máximo de corrente IRR ocorre quando a soma das tensões instantâneas sobre o IGBT e o diodo se iguala à tensão de alimentação. Quando o IGBT desliga, o resultado é uma variação de corrente, e isso faz com que o pico de sobretensão apareça devido à variação de corrente nas indutâncias parasitas. Este pico de tensão é responsável por perdas e exige um aumento no tempo morto entre a condução de dois dispositivos semelhantes quando usados numa configuração de meia-ponte, como o que será mostrado no exemplo de aplicação desse dispositivo.
Um ponto importante que deve ser levado em consideração em todo dispositivo de comutação é o Efeito Miller.
O Efeito Miller nada mais é do que a realimentação da tensão coletor-emissor (VCE) através da capacitância existente entre a porta e o coletor do dispositivo (CGC).
Isso que dizer que uma variação da tensão entre o coletor e emissor (VCE) tem o mesmo efeito que uma fonte de corrente interna no circuito de polarização , onde a intensidade desta corrente é dada pela expressão:
Infelizmente, Cgc não è constante, mudando de valor com a tensão entre coletor e emissor. As maiores variações de CCG ocorrem justamente com pequenas tensões entre emissor e coletor. Em conseqüência disso temos explicações para alguns comportamentos do IGBT:
Quando o IGBT liga (turn-on) - partindo de Vce alto e VGE igual a zero ou negativo – com uma corrente constante carregando a porta, um aumento linear da tensão de porta é obtido.
Com a queda da tensão entre coletor e emissor VCE a corrente de polarização de porta é usada para carregar CGC, e a tensão de porta permanece constante.
Mais tarde, quando a tensão entre o coletor e o emissor cai, CGC aumenta de valor de tal forma que, uma pequena variação de VCE é suficiente para levar a um aumento da corrente de porta. Somente quando a corrente necessária à carga se reduz novamente é que a tensão de porta aumenta.
Quando o IGBT desliga - partindo de Vce baixa , VGE positiva ou maior que a tensão limiar – Vth – a tensão de porta inicialmente decresce quase que linearmente (pela fonte de corrente constante de descarga). A diminuição da capacitância com o aumento da carga aumenta a tensão. Como existe uma fonte de polarização que está drenando corrente da porta, a tensão porta-emissor se mantém constante.
Em conseqüência, VCE aumenta e a maior parte da corrente de descarga da porta é usada para manter a tensão de porta constante. O processo de carga termina quando VCE alcança a tensão de operação.
É devido ao Efeito Miller que a corrente de porta durante a comutação (ligado ou desligado) é usada antes de tudo para mudar a carga CGC. Isto explica porque, carregando ou descarregando , a porta tem sua velocidade de resposta reduzida. Deve ser mencionado que as mudanças de CGC e VCC regulam por si próprias de tal forma que apenas a corrente disponível na porta é usada. Isso esclarece porque um resistor de grande valor ligado em série com a porta faz que todos os eventos que envolvam a comutação de uma IGBT tenham seu tempo de duração aumentado.
As características de tensão e corrente de um IGBT se assemelham muito com as características de um transistor MOSFET e de u transistor bipolar de potência. Para uma visualização das características de um IGBT real, apresentamos aqui o manual dos IGBT’s fabricados pela Mitsubishi, no formato .PDF.
III . Aplicações de IGBT – Um Inversor de Tensão.
Uma das aplicações de IGBT que mais são utilizadas em eletrônica de potência é a construção de inversores de tensão, os quais produzem tensão alternada através de tensão contínua. Tal processo é muito utilizado na construção de filtros ativos de potência e em sistemas de transmissão HVDC (High Voltage Direct Current) de energia elétrica. A Usina de Itaipu pertencente ao Brasil e ao Paraguai (que durante muitos anos foi a maior usina hidrelétrica do mundo) produz energia com o sistema de corrente alternada, sendo que metade da produção (pertencente ao Brasil) é gerada em 60Hz e a outra metade (pertencente ao Paraguai) é gerada em 50Hz. No entanto, boa parte da energia produzida pela parte paraguaia é vendida ao Brasil que consome tensão alternada em 60Hz. O problema foi resolvido instalando-se um retificador de potência que transforma a tensão a ser transmitida em tensão contínua e a energia é transmitida em DC até os centros consumidores (o principal é a cidade de São Paulo) onde é novamente alternada, agora em 60Hz para ser enviada aos transformadores que irão abaixar a tensão para a distribuição entre os consumidores de energia. Este inversor de tensão pode geralmente ser construído com o uso de GTO’s (Gate Turn-Off Thyristor) ou IGBT’s. No caso de inversores de tensão que serão aplicados na construção de filtros ativos de potência dá-se preferência ao emprego de IGBT’s devido à sua possibilidade de operar em elevadas freqüências.
O bloco básico de construção de um inversor de tensão usando IGBT’s é apresentado no esquema abaixo:

As tensões de porta de cada um dos IGBT’s são controladas a partir de uma Máquina de Estados Finitos, onde cada estado corresponde ao chaveamento de apenas três IGBT’s (cada um em uma associação em série diferente com um na parte de cima e outro na parte de baixo), a ordem de chaveamento é mostrada nos gráficos apresentados abaixo, onde temos as tensões em cada uma das chaves com o tempo e a tensão total entre a fase C e o neutro da associação em Y na saída do transformador apresentado na figura acima.

Assim, vemos que a forma de onda da tensão na fase C com respeito ao neutro é formada por seis segmentos idealmente retos, como mostrado na figura. Por isso, este bloco funcional é denominado de um inversor de 6 segmentos. As formas de onda nas demais fases apresentam a mesma forma de onda que a da fase C, com apenas uma diferença de fase de 120° de uma em relação à outra.
Esta forma de onda na saída é semelhante a uma forma de onda senoidal, embora ainda possua muita distorção harmônica (possui componentes harmônicos de freqüências mais altas). Para melhorar o desempenho do inversor, geralmente o que se usa é a associação de mais blocos de inversores de 6 segmentos como o mostrado acima em série, da seguinte forma apresentada na figura abaixo:

Cada um dos inversores mostrados na figura acima é idêntico ao inversor de 6 segmentos do esquema anterior e geram as mesmas formas de onda. No entanto, o primeiro transformador é do tipo Y-Y, fazendo com que a forma de onda na saída não apresente nenhuma defasagem com relação ao sinal original; já no caso do segundo transformador do tipo D-Y, temos que a saída será defasada em 30° com relação à forma de onda original. Assim, a saída deste inversor será formada pela forma de onda de 6 segmentos normal somada a esta mesma forma de onda deslocada de 30°, o que irá gerar uma forma de onda na saída de 12 segmentos como mostrado abaixo:

Como podemos ver, essa forma de onda se aproxima mais de uma senóide do que a forma de onda anterior. Para suavizar esta forma de onda de forma que se aproxime mais de uma senóide, bastando para isso utilizar um filtro passa-baixas para eliminar as componentes de altas freqüências que são responsáveis pelas transições abruptas dessa forma de onda e causam um elevado fator de distorção harmônica.
Este exemplo foi apresentado aqui para ilustrar uma forma de aplicação do IGBT na prática, como uma chave em aplicações de elevadas potências.
Nenhum comentário:
Postar um comentário